EQUIPMENT
다양한 산업 분야의 새로운 혁신에 기여합니다
-
Sample Preparation : Mechanical method
Prepare samples for SEM, STEM, FIB-SEM and optical inspection
-
Sample Preparation : Ion beam
Prepare samples for SEM, STEM, FIB-SEM and optical inspection
-
FE-SEM, FIB, Dual Beam
Cross-section imaging failure analysis and TEM sample preparation
-
Sample Preparation : Mechanical method
Prepare samples for SEM, STEM, FIB-SEM and optical inspection

-
Sample Preparation : Ion beam
Prepare samples for SEM, STEM, FIB-SEM and optical inspection

-
FE-SEM, FIB, Dual Beam
Cross-section imaging failure analysis and TEM sample preparation
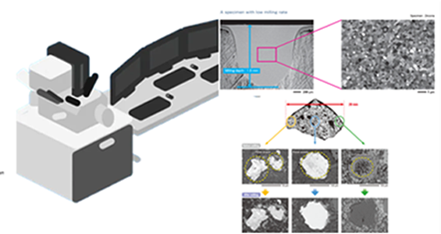
보유장비 활용분류
Sample preparation : Mechanical Method
비파괴 검사만으로는 해명할 수 없는 과제에 대해, 단시간 또한 정확하게 원인을 특정하기 위한 파괴 검사용 시료를 말한다. 신뢰성 시험에서 시험 전후의 상태를 확인하거나 불량 해석이나 구조 해석을 실시하기 위해서는 시료의 단면을 관찰하는 것이 매우 중요합니다.
시료의 단면을 Ar 이온빔으로 깎아내어 작성할 수 있습니다. 기계 연마로 생겨 버리는 데미지층을 형성하지 않고, 깨끗한 단면을 만들 수 있으므로, 미세한 층 구조나 미립자의 SEM 단면 관찰

Sample Preparation : Ion Beam
시료의 내부 상태를 조사하기 위해서는 단면 시료를 만들어 관찰하는 것이 효과적이며 그 중 broad Ion beam을 이용한 가공의 위치정밀도는 10 um 정도이지만 1 mm를 넘는 영역의 단면을 제작할 수 있는 장점을 갖고 있다.
broad Ion beam은 기계연마에 비해 개재물의 이동이나 가공 변형이 거의 일어나지 않는다. 또 기존의 방법에서는 어려웠던 부드러운 재료와 단단한 재료가 혼합된 시료에서도 경면 마무리가 가능하여 도금층 사이의 밀찰도나 본딩 면의 보이드 등, 기존의 연마에서는 찌그러져 버렸던 간극의 구조가 보존된 채로 단면을 형성할 수 있다.
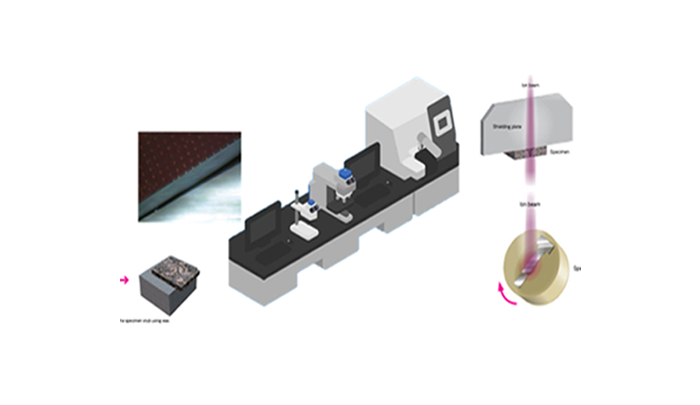
FE-SEM, FIB, Dual Beam
SEM 기기 활용
나노미터의 분해능과 높은 효율의 검출력으로 다양한 시료를 분석 Inlens 감지 신호가 선명도 높은 이미지를 빠르고 샘플 손상을 최소화 저전압에서 고해상도 및 대비로 나노 스케일 분석이 가능 이온빔 단면 가공진행 후 표면 분석
FIB, Dual Beam 기기 활용
1) Imaging
시료에 빔이 주사될 때 시료에서 튀어나오는 입자로서 이온과 전자가 있다. 이것을 이차이온 (Secondary Ion) 그리고 이차전자 (Secondary Electron)라 한다. 이러한 2차 신호를 센서로 검출하여 컴퓨터 화면에 표시하여 빔을 조사한 영역의 현미경상을 관찰할 수 있다.
2) Milling
FIB source에 높을 가속전압을 가해 이온을 발생시키고 전계(Electric Field)를 이용하여 이를 조절하여 이온을 선택적 영역에 일정한 세기로 주사하여 시료의 원하는 부분(넓이, 깊이)을 가공한다.